COF 是一种 IC 封装技术,是运用柔性电路板 FPC 作为封装芯片的载体,透过热压合将芯片上的金凸块(Gold Bump) 与软性基板电路上的内引脚(Inner Lead) 进行接合(Bonding) 的技术。
COF 生产完成后,待液晶显示器(LCD Panel) 模块工厂取得 IC 后,会先以冲裁(Punch) 设备将卷带上的 IC 裁成单片, 通常 COF 的软性基板电路上会有设计输入端(Input) 及输出端(Output) 两端外引脚(Outer Lead), 输入端外引脚会与液晶显示器玻璃基板做接合, 而输入端内引脚则会与控制信号之印刷电路板(PCB) 接合。
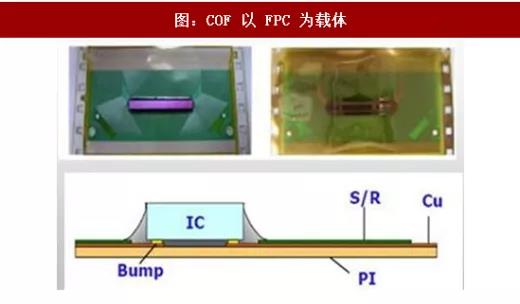
COF 以 FPC 为载体
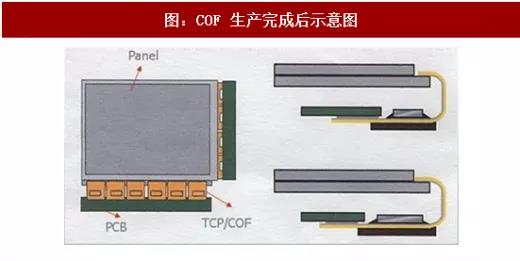
COF 生产完成后示意图
COF 在芯片封装过程中,起到承载芯片、电路连通、绝缘支撑的作用,特别是对芯片起到物理保护、提交信号传输速率、信号保真、阻抗匹配 、应力缓和、散热防潮的作用。
另外, COF 具有配线密度高、重量轻、厚度薄、可折叠、弯曲、扭转等优点,是一种新兴产品,有利于先进封装技术的使用和发展。
COG 是将芯片直接绑定在玻璃面板上,而 COF 是将驱动芯片绑定在软板上。COF 的优势在于可以实现窄边框,主要系芯片直接绑定在 FPC 上从而减少了玻璃基板的占用。
COG 的优势在于轻薄,不用增加 FPC 的封装厚度。相比于 COG,COF 可以将边框缩小至 1.5mm 左右,减少端子部长度。
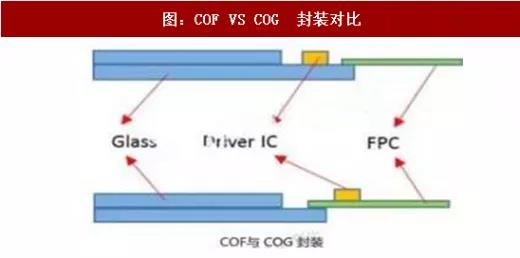
COF VS COG 封装对比

COG 与COF 技术实现方案(绿色 IC,蓝色 FPC)

COF 产品
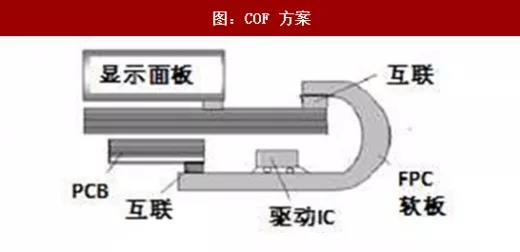
COF 方案
京东方、天马、龙腾、友达、群创等本土面板厂都已经有 18:9 产品,尺寸大小集中在 5.7 寸和 5.99 寸;中低端智能手机仍以 a-Si(HD+)及 LTPS(FHD+) 为主,而高端产品一般会选用 OLED 屏(主要运用 COF 技术)。
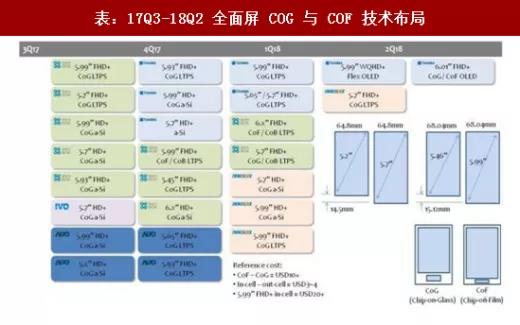
17Q3-18Q2 全面屏 COG 与 COF 技术布局
COF 方案的 FPC 主要采用 PI 膜,线宽线距在 20 微米以下,FPC 制作工艺主要以半加成法、加成法为主,减成法无法满足线宽线距的精度要求。
目前,COF 技术主要被日韩厂商垄断,台系厂商欣邦、易华电等也有所突破,本土企业中,丹邦科技以生产单面 COF 产品为主,京东方、深天马均在大力研究双面 COF,弘信电子正积极研究 COF 全制程技术,以迎接全面屏带来的市场机遇。

制程工艺能力比较
上达电子投资国内首条 COF 产线,填补 COF 高端制造领域空白, 2017 年 6 月 20 日签约仪式在邳州举行,此次签约的 COF 项目总投资将达 35 亿元。
项目将建设现代化智能工厂,引入国际生产团队,引进进口专业生产和检测设备。产品则将采用业内最先进的单面加成法工艺、双面加成法工艺生产 10 微米等级的单、双面卷带 COF 产品,全制程以卷对卷自动化方式生产。
目前全球 COF 制造企业,能量产 10 微米等级的制造商只有 5 家企业,分别为韩日台企。上达电子 COF 项目的投产将填补国内在 COF 高端制造领域的空白,实现柔性 OLED 显示产业关键原材料和元器件的国产化。
OLED 渗透率逐渐提升,“卷对卷”工艺不可或缺:OLED 的细线路只有卷对卷生产线才能满足技术需求。深联电子是国内第一家配备双面卷对卷生产线的企业。卷对卷生产线的自动化程度高、效率高、产品精度高,特别适合细线路、基材比较薄的 软板产品。
卷对卷工艺是采取成卷铜箔绷直方式,对产品的平整度有保障,有利于细线路产品生产,因此公司导入的卷对卷生产线主要针对高端显示模组;而片对片生产在产品转移的过程中,人为因素对产品品质影响较大。
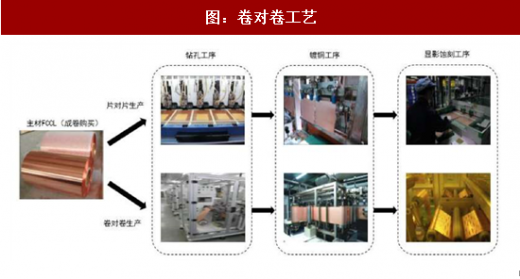
卷对卷工艺

 平板电脑摄像头FPC
平板电脑摄像头FPC POS机天线FPC
POS机天线FPC POS机天线FPC
POS机天线FPC 手机天线FPC
手机天线FPC